
스테이션 리볼링 BGA 기술
1. BGA 리볼링 스테이션 분야의 최신 기술.
2. 가열 시스템 및 광학 정렬 시스템에 최신 기술이 채택되었습니다.
3. 재고 있음! 주문을 환영합니다.
4. 다른 마더보드의 다른 칩을 리볼할 수 있습니다.
설명
스테이션 리볼링 BGA 기술
Station reballing BGA 기술은 BGA(Ball Grid Array) 칩에서 솔더 볼을 교체하는 프로세스를 말합니다.
BGA는 칩이 PCB에 실장되는 집적 회로에 사용되는 표면 실장 패키징 유형입니다.
솔더의 작은 볼 배열을 사용합니다.


1. 자동 스테이션 Reballing BGA 기술 적용
모든 종류의 마더보드 또는 PCBA와 함께 작동합니다.
땜납, reball, 다른 종류의 칩 제거: BGA,PGA,POP,BQFP,QFN,SOT223,PLCC,TQFP,TDFN,TSOP,
PBGA, CPGA, LED 칩.
2. 제품의 특징자동 스테이션 Reballing BGA 기술

3. 사양자동 스테이션 Reballing BGA 기술

4. 세부사항자동 스테이션 Reballing BGA 기술
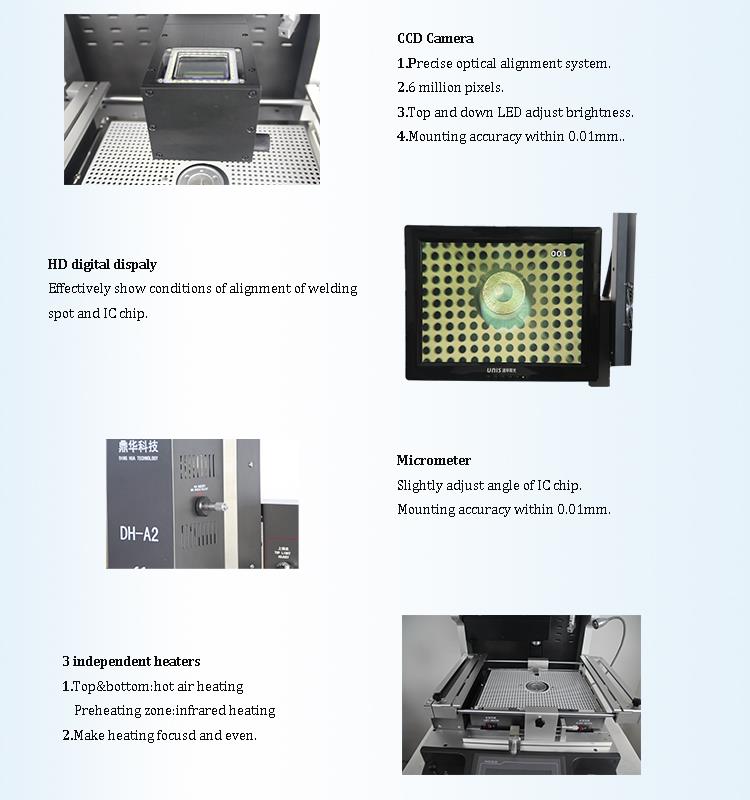

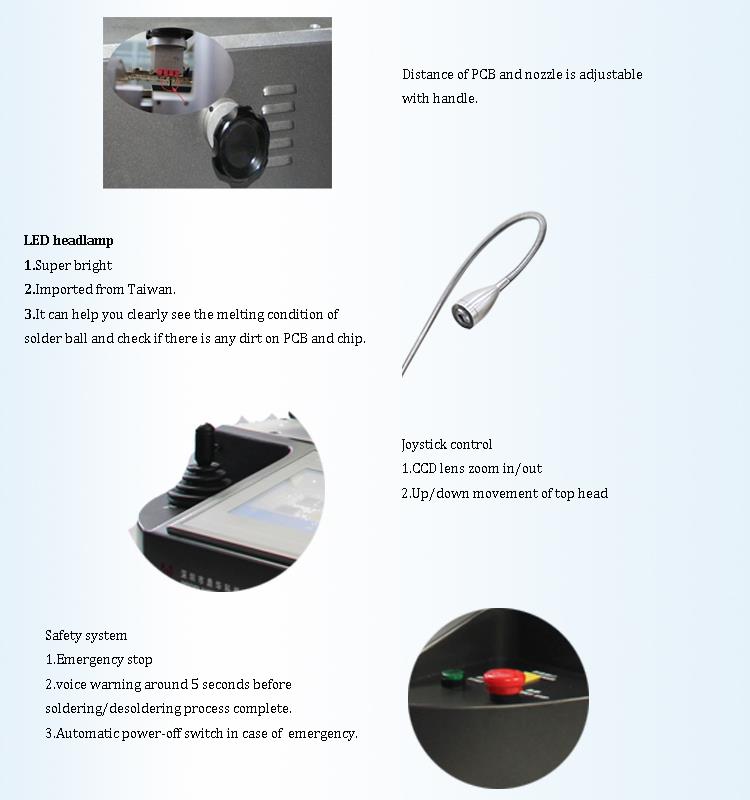
5. 우리를 선택하는 이유자동 스테이션 Reballing BGA 기술?


6.증명서자동 스테이션 Reballing BGA 기술
UL, E-MARK, CCC, FCC, CE ROHS 인증서. 한편, 품질 시스템을 개선하고 완벽하게 하기 위해,
Dinghua는 ISO, GMP, FCCA, C-TPAT 현장 감사 인증을 통과했습니다.

7. 포장 및 배송자동 스테이션 Reballing BGA 기술

8. 선적자동 스테이션 Reballing BGA 기술
DHL/TNT/페덱스. 다른 운송 기간을 원하시면 알려주십시오. 우리는 당신을 지원할 것입니다.
9. 지불 조건
은행 송금, 웨스턴 유니온, 신용 카드.
다른 지원이 필요한 경우 알려주십시오.
10. Station Reballing BGA Tech의 운영 데모?
11. 관련 지식
올바른 리플로우 프로세스:
리플로 솔더링 기술은 많은 사람들이 생각하는 것처럼 간단하지 않습니다. 특히 다음을 수행해야 하는 경우
제로 결함 및 용접 신뢰성(수명) 보장을 달성합니다. 내 경험을 당신과 공유할 수 있는 것은
당분간.
양호한 리플로우 솔더링 프로세스를 보장하려면 다음을 수행해야 합니다.
1. 최대 온도와 같은 PCBA의 품질 및 납땜 요구 사항 이해
수명에 가장 필요한 요구 사항 및 솔더 조인트 및 장치;
2. 솔더 페이스트가 인쇄된 부분과 같은 PCBA의 솔더링 어려움 이해
패드보다 큰 부분, 피치가 작은 부분 등;
3. PCBA에서 가장 뜨거운 지점과 가장 차가운 지점을 찾아 그 지점에서 열전쌍을 납땜합니다.
4. BGA 패키지와 같이 열전쌍 온도 측정이 필요한 다른 장소를 결정합니다.
및 하단 솔더 조인트, 열에 민감한 장치 본체 등(모든 온도 측정 채널을 사용하여
가장 많은 정보)
5. 초기 매개변수를 설정하고 공정 사양(주 9) 및 조정과 비교하십시오.
6. 납땜된 PCBA를 현미경으로 주의 깊게 관찰하여 모양과 표면 상태를 관찰하였다.
솔더 조인트의 젖음 정도, 주석 흐름의 방향, 잔류물 및 솔더 볼
PCBA. 특히 위의 두 번째 항목에 기록된 용접 난관에 더욱 주의를 기울여야 합니다. 일반적으로
위의 조정 후에 용접 결함이 발생하지 않습니다. 단, 고장이 있는 경우 고장모드 분석을 위해
상부 및 하부 온도 영역 제어와 일치하도록 메커니즘을 조정하십시오. 이상이 없다면 판단
결과 곡선과 보드의 솔더 조인트 상태에서 미세 조정 최적화를 수행합니다. 목표는
설정 프로세스를 가장 안정적이고 덜 위험하게 만듭니다. 조정을 고려할 때 용광로를 고려하십시오.
부하 문제와 생산 라인 속도 문제를 해결하여 품질과 출력 사이의 균형을 잘 잡습니다.
위 공정 곡선의 조정은 실제 제품으로 결정해야 합니다. 테스트 보드를 사용하여
실제 제품은 비용이 문제가 될 수 있습니다. 일부 사용자는 매우 비싼 보드를 조립하여 사용자에게
온도를 자주 테스트하지 않으려고 합니다. 사용자는 시운전 비용과
문제. 또한 가짜, 스크랩 보드 및 선택적 사용으로 테스트 보드 비용을 추가로 절약할 수 있습니다.
놓기.







