설명
BGA 재 작업 납땜 스테이션


1. 광학 정렬 BGA Reballing Station의 적용
의료 산업, 통신 산업, 자동차 산업 등 컴퓨터, 스마트 폰, 노트북, MacBook 로직 보드, 디지털 카메라, 에어컨, TV 및 기타 전자 장비의 마더 보드를 수리 할 수 있습니다.
솔더, 리볼, 칩의 다른 종류의 납땜 제거 : BGA, PGA, POP, BQFP, QFN, SOT223, PLCC, TQFP, TDFN, TSOP, PBGA, CPGA, LED 칩.
2. 광학 정렬 BGA Reballing Station의 제품 특징

진공 노즐이 설치되어 상부 노즐을 픽업, 교체 및 납땜 제거 등에 편리합니다.

정렬에 사용되는 모니터 화면, 1080P, 15 인치.
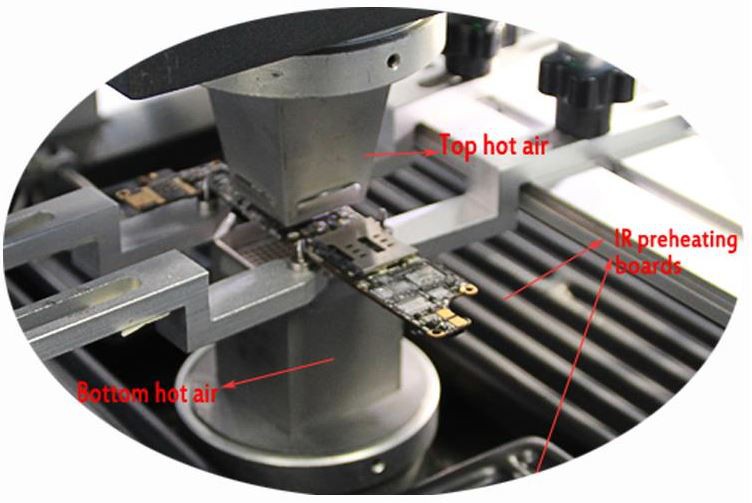
2 개의 열풍 히터 및 1 개의 적외선 예열 영역, 납땜 및 납땜 제거를위한 열풍 히터, 적외선 예열
큰 마더 보드를 예열하여 마더 보드를 보호합니다.

수입 된 LED 조명, 10W. 큰 PCB를 선명하게 볼 수있을 정도로 밝습니다.

스틸 메시 인클로저는 적외선 예열 영역 위에 설치되어 작업자가 부상을 당하지 않도록 보호 할 수 있습니다.
고르게 가열 되더라도 작은 부품이 내부에 떨어지지 않는 경우에도 마찬가지입니다.
* 칩 수준의 수리 속도가 빠릅니다. 모든 납땜 조인트의 정확한 온도 제어 및 정밀한 정렬.
* 3 개의 독립적 인 가열 영역이 정확한 온도를 보장합니다. ± 1ºC의 편차. 다른 마더 보드에 따라 화면에서 다른 온도 프로파일을 설정할 수 있습니다.
* 6 억 픽스 Panasonic 독자적인 CCD 카메라는 모든 납땜 조인트의 정확한 정렬을 보장합니다.
* 작동하기 쉽습니다. 특별한 기술이 필요하지 않습니다.
3. 광학 정렬 BGA Reballing Station 지정

4. 왜 광학 정렬 BGA Reballing Station을 선택해야합니까?


5. 광학 정렬 BGA Reballing Station 인증서
우수한 제품을 제공하기 위해, 심천 DINGHUA 기술 개발 주식 회사는 UL, E-MARK, CCC, FCC, CE ROHS 인증서를 통과 한 최초의 회사입니다. 한편, 품질 시스템을 개선하고 완벽하게하기 위해 Dinghua는 ISO, GMP, FCCA, C-TPAT 현장 감사 인증을 통과했습니다.

6. 포장&앰프; 광학 정렬 BGA Reballing Station 선적

7. 선적광학 정렬 BGA Reballing Station
우리는 DHL / TNT / FEDEX를 통해 기계를 발송할 것입니다. 다른 배송 조건을 원하면 알려주십시오. 우리는 당신을 지원할 것입니다.
8. 지불 조건
은행 송금, 웨스턴 유니온, 신용 카드.
다른 지원이 필요하면 알려주십시오.
10. 광학 정렬 BGA 및 수동 BGA 재 작업 스테이션에 대한 작은 팁 :
BGA 납땜 제거 공정은 심오하고 미묘하므로 좋은 효과를 얻으려면 적절한 기술과 단계를 습득해야합니다 .BGA 칩을 용접하기 전에 습기를 제거하기 위해 PCB와 BGA를 일정한 온도의 오븐에서 구워야합니다 80ml 90 ℃ 20 시간 동안 수분의 정도에 따라 베이킹 온도와 시간을 조정하십시오. 포장을 풀지 않고 PCB와 BGA를 직접 용접 할 수 있습니다. 다음 사항을 모두 수행 할 때 정전기 링이나 정전기 방지 장갑을 착용하는 데 특히주의해야합니다. BGA 칩의 손상을 피하기위한 작업.
BGA 칩을 용접하기 전에 PCB 패드에 BGA 칩을 정확하게 정렬해야합니다. 광학 정렬과 수동 정렬의 두 가지 방법이 있습니다. 현재 수동 정렬이 주로 사용됩니다. 즉, 스크린 인쇄 라인 PCB의 BGA와 패드가 정렬됩니다.
BGA 및 PCB 정렬 기술 : BGA와 실크 스크린을 정렬하는 과정에서 솔더 볼이 패드에서 약 30 % 벗어난 경우에도 완전히 정렬되지 않은 경우에도 용접 할 수 있습니다. 용융 과정에서, 틴 볼과 틴 패드 사이의 장력으로 인해 틴 볼이 패드와 자동으로 정렬됩니다. 정렬 작업이 완료된 후 PCB를 BGA 리턴 테이블의 브래킷에 놓고 BGA 리턴과 수평이되도록 고정합니다. 적절한 열풍 노즐 (즉, 노즐 크기가 BGA보다 약간 큼)을 선택한 다음 해당 온도 곡선을 선택하고 용접을 시작하고 온도 곡선이 완료 될 때까지 기다렸다가 냉각 한 다음 BGA를 완료하십시오. 용접.
생산 및 디버깅 과정에서 BGA 손상 또는 기타 이유로 인해 BGA를 교체하는 것은 불가피합니다 .BGA 수리 테이블은 BGA를 분해 할 수 있으며 BGA의 분해는 BGA 용접의 역 프로세스로 간주 될 수 있습니다. 온도 곡선이 완료된 후 BGA는 진공 펜으로 흡입해야하고 핀셋과 같은 다른 도구는 너무 많은 힘을 가하여 패드의 손상을 피하기 위해 사용되지 않습니다. 핫 PCB는 예열 기능과 동일하기 때문에 주석을 제거하는 작업이 더 쉬워 질 수 있습니다. 주석 흡입 라인은 여기에 사용되며 PCB의 패드가 평평한 지 확인한 후 패드를 손상시키지 않도록 작업에 너무 많은 힘을 가하지 마십시오 .BGA의 용접 작업을 시작할 수 있습니다.
제거 된 BGA를 다시 용접 할 수 있지만 볼을 다시 용접하기 전에 주입해야합니다. 볼을 심는 목적은 BGA의 패드에 주석 볼을 다시 심는 것입니다.
위의 BGA 용접 및 분해 공정 기술을 사용하면 용접 성장 방식에 대한 우회가 줄어들고 결과가 더 빠르고 효율적이 될 것입니다.이 기사의 경험을 공유하면 BGA 용접에 대한 영감을 얻을 수 있기를 바랍니다. 그리고 분해.











